半導体製品の再利用も手段の一つに。
........
- 更新日
- 2023.05.09
- 公開日
- 2022.01.25

部品調達やEOL製品入手に苦慮した場合、市場品の入手の他に「再利用」という手段も持っておきませんか?リユースって本当に大丈夫なの…そんな不安をお持ちの方に、弊社の業務パートナーが所有する非加熱Remove技術を解説します。
1. 特に困るのがBGAタイプ

BGA(Ball Grid Array)タイプのパッケージは取り外しが困難な部品とされております。
そんなとき、当社の業務パートナーが所有する非加熱Remove技術(加熱処理を行わない、最小限の部品へのストレスで取り外しを可能とする技術)でお手伝いさせていただきます。
2. こんなお悩みございませんか?
- リフロー回数制限があり熱で除去したくない
- 熱で除去しようとすると周辺部品の品質に不安がある
- 封止材があり熱をかけられない
- ベースが高放熱基板で加熱除去できない
3. ただ、半導体の再利用や入手性困難な製品を使えるだけじゃない
リボールすることで、3つのメリットもございます。
- デバイスの不具合箇所の特定(不具合解析)による故障箇所の早期発見で製品の品質を向上
- はんだボール付けに起因する不具合の場合、リボールして再利用することで製造コストを低減
- 新規パッケージの開発など、試作品等の少量生産でもリボールでサンプルを有効活用
4. BGAパッケージのリユースで押さえておきたい大きな流れ
実装済み基板よりBGAパッケージの取り外しを行い、さらにリボール(はんだボールの再搭載)を実施いたします。これにより取り外した製品はリユース可能な状態となります。

BGA取り外し
当社取り扱いの非加熱Remove技術の特徴
BGA切削装置により非加熱で基板からBGAパッケージを取り外しいたします。
BGA切削装置は、切削により表面実装された半導体製品を非加熱で取り外しする装置です。また薬剤不使用のためアンダーフィルへの対応も可能です。
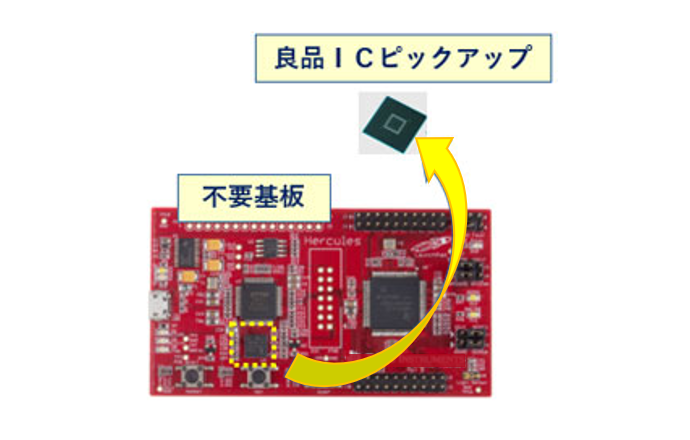
この手法は、次のような表面実装部品の取り外しに適した手法です。
- 狭ピッチ実装された部品
- リフローの回数制限がある基板の部品
- 両面基板の実装部品
- 放熱基板の実装部品
<BGA切削装置>
-
BGA切削装置
デスクトップ型(マニュアル機) -
BGA切削装置
自立型(自動機)
BGA切削装置の運用事例
BGA切削装置により非加熱で基板からBGAパッケージを取り外します。
BGA切削装置は、切削により表面実装された半導体製品を非加熱で取り外しする装置です。また薬剤不使用のためアンダーフィルへの対応も可能です。
【BGAパッケージを取外し再利用する場合】
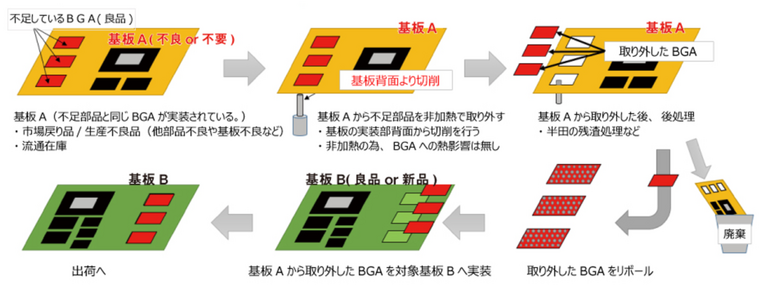
【不具合のBGAパッケージを除去して基板を再利用する場合】
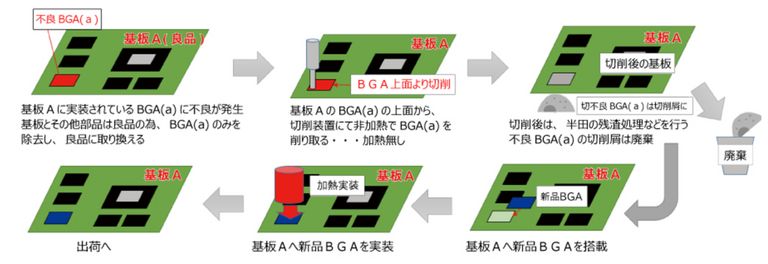
リボール
リボールは、基板から取り外したBGAパッケージにはんだボールを再搭載することです。これにより製品の再利用が可能となります。これはCSP(Chip-scale Package)製品にもご活用いただけます。
- 対応可能なボール径がございます。詳細はお問い合わせください。
リボール作業フローの説明
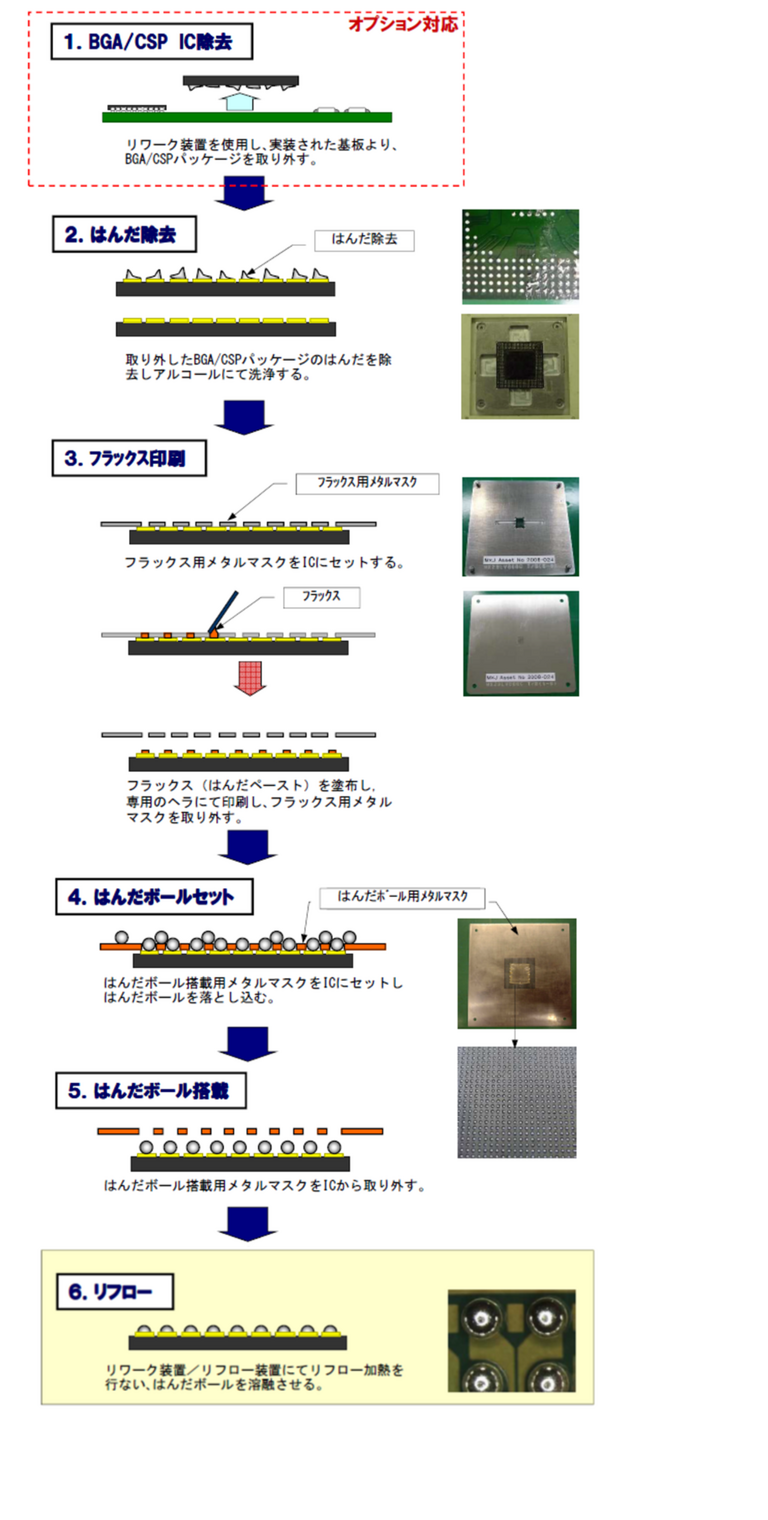
<リボール装置>
-
BGAリワーク装置 -
N2リフロー装置








